近日特斯拉“We Robot”发布会成功举办,颠覆性的无人驾驶出租车“Cybercab”与智能人形机器人Optimus在发布会中惊艳亮相,两款产品的发布无疑标志着全球自动驾驶与人工智能系统相关技术的又一次重大突破。

如今自动驾驶、人工智能技术的新一轮爆发式发展正在改变全球半导体产业格局,最新技术对高性能、高算力芯片的巨大需求,推动着半导体产业不断创新,并由此迎来巨量的增长空间。如何抓住半导体产业链重构的机会,已成为业界各方关注的重点。
LASER
面向半导体行业迫切发展需求,华工激光凭借多年激光装备智造经验,深耕半导体行业,围绕微电子元器件产业链两大基础材料——基板+芯片,延伸至产业链上游的衬底/晶圆和下游的封装/封测领域进行布局,为全球行业客户提供“激光+封装+检测”全制程智能解决方案。
顺应国产替代发展浪潮,华工激光PCB微电子事业部坚持自主研发、持续技术创新,推动半导体加工装备国产化进程加快,自主研发的半导体芯片封装后激光切割装备与半导体芯片封装后激光打标智能装备等智能装备的关键性能指标均已达到国际先进水平,打破进口产品垄断,在成本与交付周期上都具备相当竞争力,显著强化国内半导体产业链自主可控能力,提高了产业链的安全性与稳定性,为半导体行业的持续发展注入了强劲动力。
•✦全制程行业智能解决方案✦•
半导体芯片封装后激光切割智能装备

在半导体加工工艺中,激光切割作为非接触式加工方式,有效避免了传统切割方式可能带来的损伤,确保了半导体器件的完整性和可靠性,对于提升半导体器件的封装质量、降低生产成本、缩短产品上市周期具有重要意义。
华工激光自主研发半导体芯片封装后激光切割智能装备,将传统面阵相机升级为高精度线扫相机,通过高精度控制系统和高速线扫视觉系统实现快速高效的全自动激光切割,大幅度提升设备UPH和产品切割精度,不仅显著提高了半导体制造的生产效率,更在精度和可靠性上实现了质的飞跃。
显著优势
高效生产:高速线扫视觉系统+双平台切割系统,UPH提升300%;
高速专精:搭载自研高功率固体绿光激光器, 针对1-2mm厚度芯片切割效率大幅提升;
稳定可靠:先进光路系统结合大理石工作平台,切割精度<±25μm,设备CPK>1.67
关键指标
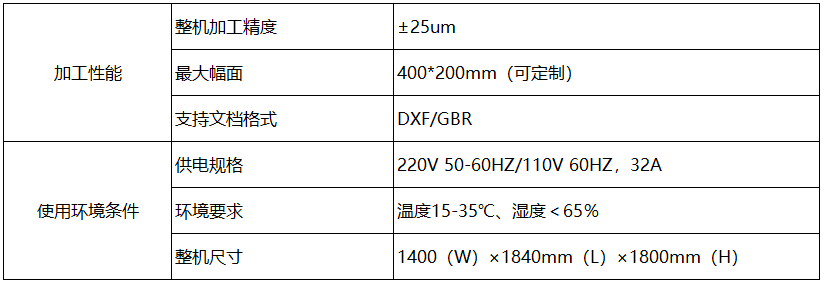
半导体芯片封装后激光打标智能装备

半导体芯片封装后的标识是品质追溯的关键。华工激光打造半导体芯片封装后激光打标智能装备,用于封装芯片封面打标。设备采用激光打标先进技术,通过OCR检测标识后效果,结合MES系统数据实时解析加工、同步数据反馈,为半导体器件提供清晰、准确的标识,不仅提升了半导体器件的标识质量和可读性,更通过稳定可靠的品质追溯,帮助客户实现对半导体器件的全生命周期管理,从生产到销售、再到售后服务,每一个环节都能得到精准记录和追溯,为半导体产业的品质管理提供了有力支持。
产品优势
高精标识:适应翘曲度2~5mm,产品进行打标精度±0.05mm;
兼容性好:可兼容翘曲板、平板、软板全自动化打标,可搭配不同类型激光打标机,使用料片180~270mm(长)50~100mm(宽);
高自动化:自动弹匣上料+自动激光打标+自动弹匣下料,显著减少人力成本投入;
系统管理:软件自主开发,可实现客户端MES数据系统对接,方便统一管理
国产替代理想之选
长期以来,半导体加工装备领域一直受到德国、日本、韩国等国外品牌的垄断,国内封测厂不得不依赖德国ROFIN、韩国EO等进口设备。
随着我国半导体产业的快速发展和国产替代的深入推进,华工激光作为中国激光工业化的开创者、引领者,凭借其强大的研发能力与深厚的技术积淀,针对半导体芯片封装后段的关键制程,成功打造了包含半导体芯片封装后激光切割装备与半导体芯片封装后激光打标智能装备在内的一系列高端半导体制造设备,性能整体水平达到国际一流水平,在半导体制造中发挥了重要作用,更为半导体产业的持续发展和创新提供了有力支持。
同时,华工激光“激光+封装+检测”全制程智能解决方案的推出不仅填补了国内在这一领域的发展空白,更以卓越的性能和稳定的质量,赢得了广大客户的信赖和好评,成为国产替代的理想之选。
HGTECH
未来,华工激光将继续深耕半导体领域,在探索与创新的征途中,坚持打造更多国产替代、专精特新产品,以更加先进的技术和更加贴心的服务,抓住半导体产业链重构的机会,为半导体产业的繁荣贡献更多智慧和力量。